〈觀察〉先進封裝技術戰開打 台積電利器出鞘、三星拚彎道超車
鉅亨網記者林薏茹 台北
摩爾定律面臨越來越多挑戰,半導體產業正逐步邁向「後摩爾定律」時代,台積電繼先前以 InFO(整合扇出型封裝) 封裝技術一路獨拿蘋果 iPhone 處理器大單後,近期也整合前後段 3D IC 封裝推出新平台,而三星也不甘示弱,以 3D IC 封裝技術 X-Cube 要與台積電展開競爭。
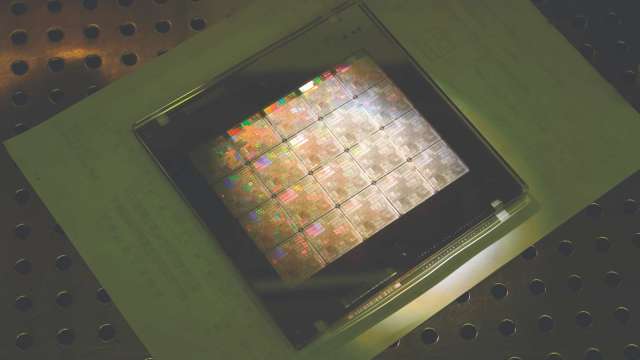
隨著先進製程技術逼近物理極限,摩爾定律在 2D 晶片微縮上,面臨越來越多挑戰,不足支撐製程需求,半導體產業逐步進入「後摩爾定律」時代。
透過 Chiplet (小晶片)、異質整合、3D 堆疊技術,可替摩爾定律「延壽」,也使封裝技術漸漸由傳統封裝走向先進封裝,朝系統級、晶圓級等先進封裝技術邁進。
台積電、三星、英特爾均積極跨入先進封裝領域。在半導體技術爭奪戰中,戰場由晶圓代工先進製程,延伸至先進封裝,若能一路從前段做到後段先進封裝,打造一條龍的高度整合供應鏈,就能與客戶間達成更緊密的連結合作。
蘋果 iPhone 處理器訂單就是最佳例子,早期由三星以超薄的 PoP (Package on Package) 多重晶片封裝技術,獨攬 iPhone 處理器訂單;但從 A11 處理器開始,台積電以全新的 InFO(整合扇出型封裝) 封裝技術作為敲門磚,一路獨拿 iPhone 處理器大單,也因其在先進封裝技術上的成功,蘋果 iPhone 處理器訂單,從此由台積電獨霸一方。
三星目前位居晶圓代工二哥,在先進製程技術上仍落後台積電,為了不重演當年台積電以 InFO 封裝技術力奪蘋果大單的慘痛經驗,三星也積極佈局先進封裝製程技術。
三星日前對外展示 3D IC 封裝技術 X-Cube,將邏輯與 SRAM 向上堆疊,以減少晶片面積,再以直通矽穿孔 (TSV) 技術,提升系統整合晶片資料處理速度,著眼高效運算處理器、5G 連網數據晶片、AI 運算晶片等應用,目前已在旗下 7 奈米與 5 奈米製程技術進行驗證。
台積電也在今年度技術論壇上,對外宣布推出 3D Fabric 平台,平台包含其系統整合晶片 (TSMC-SoIC) 技術、CoWoS 技術、及整合型扇出 (InFO) 技術,可將多個邏輯晶片連結在一起,甚至串連高頻寬記憶體、異質小晶片或特殊製程晶片等,提升系統效能與功能性,並縮小尺寸外觀。
台積電努力實現電晶體微縮,但也發現 2D 微縮不足以支撐製程需求,以微縮、先進封裝雙頭並進,而三星在先進製程上仍落後台積電,正加速推進其 3D IC 封裝技術;隨著 3D IC 技術已具備可行性,未來雙方戰場可望延伸至先進封裝領域,台積電力守產業龍頭地位,三星則力拚以先進封裝彎道超車。
- 弱勢美元來襲!2026 歐日圓操作全攻略
- 掌握全球財經資訊點我下載APP
鉅亨贏指標
了解更多#一紅吃三黑
延伸閱讀
- 講座
- 公告
上一篇
下一篇
